QR коды

Біз туралы
Өнімдер
Бізбен хабарласыңы

Телефон

Факс
+86-579-87223657

Электрондық пошта

Мекенжай
Вангда жолы, Зияг көшесі, Вуй округ, Джинхуа қаласы, Чживян провинциясы, Қытай
Силикон эпитаксиіҚазіргі жартылай өткізгіш өндірістегі шешуші негізгі процесс. Бұл белгілі бір кристалды кремнийдің бір немесе бірнеше қабаттарының бір немесе бірнеше қабаттарының бір немесе бірнеше қабаттарының бір немесе бірнеше қабаттарын, қалыңдығы, допинг концентрациясы және дәл жылтыратылған бір кристалды кристалды силикон субстратымен типі бар. Бұл өскен фильм эпитаксиальды қабат деп аталады (эпитаксиальды қабат немесе эпи қабаты), ал эпитаксиалды қабатпен семірондық вафли эпитаксиальды кремний вафли деп аталады. Оның негізгі сипаттамасы - жаңадан өсірілген эпитаксиалды кремний қабаты - кристаллографиядағы субстрографиядағы субстрография құрылымының жалғасы, бұл субстрографиядағы субстрат, субстрография ретінде бірдей кристалды құрылымды қалыптастырады. Бұл эпитаксиальды қабатқа субстраттың дәл жобаланған электрлік қасиеттері болуы мүмкін, осылайша жоғары өнімді жартылай өткізгіш құрылғыларды өндіруге негіз береді.
![]()
Силикон эпитаксиіне арналған тік эпитаксициялық сезімтал
1) анықтама: Кремний эпитаксиі - кремний атомдарын кремді атомдарды химиялық немесе физикалық әдістермен бір кристалды силикон субстратымен салады және жаңа кристалды кристалды кристалды кристалды кристалды кристалды кремсиконға айналдырады.
2) торды сәйкестендіру: Негізгі ерекшелігі - эпитаксиальды өсудің тәртібі. Кепілмеген кремний атомдары кездейсоқ жиналмайды, бірақ субстраттың «шаблон» (шаблон »басшылығымен, субстраттың бетіне атомдар бетіне берілген, атомдық деңгейдің дәл көшірмесі бойынша орналастырылған. Бұл эпитаксиальды қабаттың поликристалды немесе аморфты емес, сапалы жалғыз кристалл екенін қамтамасыз етеді.
3) бақылау мүмкіндігі: Силикон эпитакси процесі өсу қабатының қалыңдығын (нанометрлерден микрометрлерге), допинг түрін (N-Type немесе P-type) және допинг концентрациясын дәл бақылауға мүмкіндік береді. Бұл бірдей кремний вафлиінде әр түрлі электрлік қасиеттері бар аймақтарға мүмкіндік береді, бұл кешенді біріктірілген тізбектерді шығарудың кілті болып табылады.
4) интерфейс сипаттамалары: Интерфейс эпитаксиальды қабат пен субстрат арасында пайда болады. Ең дұрысы, бұл интерфейс атомдық тегіс және ластанудан босатылады. Алайда, интерфейстің сапасы эпитаксиальды қабаттың жұмысы үшін өте маңызды, ал кез-келген ақаулар немесе ластану құрылғының соңғы жұмысына әсер етуі мүмкін.
Кремнийдің эпитаксиалды өсуі негізінен кремний атомдары үшін дұрыс энергия мен қоршаған ортаны субстраттың бетке көшіп, ең төменгі қуат қабатын табуға байланысты болады. Қазіргі уақытта қолданылатын технология - химиялық будың тұнбасы (CVD).
Химиялық будың тұнбасы (CVD): Бұл кремний эпитаксиіне қол жеткізудің негізгі әдісі. Оның негізгі қағидаттары:
● Прекурсорлық көлік: Silane (SIH4), дихлоросилан (SIH4), дихлоросилан (SIKH2CL2) немесе трихлоросилан (SIKHCL3), және допангиялық газды (N-Type Doping және Dopant)) дәл пропорцияларға араластырады және жоғары температуралы реакция камерасына бөлінген.
● Беттік реакция: Жоғары температурада (әдетте 900 ° C және 1200 ° C-қа дейін), бұл газдар жылытылатын кремний субстратының бетіне химиялық ыдырауға немесе реакцияға ұшырайды. Мысалы, SIH4 → SI (қатты) + 2H2 (газ).
● Беткі көші-қон және нуклеация: DecomPosition шығарған кремний атомдары субстрат бетіне адсорбцияланған және бетіне қоныс аударады, сайып келгенде, біріктіріліп, жаңа сингл қалыптастыру үшін дұрыс тор сайтын табыңызкристалды қабат. Эпитаксиандық өсудің кремнийінің сапасы көбінесе бұл қадамды бақылауға байланысты.
● Қабатталған өсім: Жаңадан жиналған атом қабаты субстраттың торшысын үнемі қайталайды, қабат қабатын қабатпен өсіреді және белгілі бір қалыңдығы бар эпитаксиальды кремний қабатын құрайды.
Негізгі процестің параметрлері: кремний эпитакси процесінің сапасы қатаң бақыланады, ал негізгі параметрлер мыналарды қамтиды:
● Температура: Реакция жылдамдығына, беттік мобильділік пен ақаулардың пайда болуына әсер етеді.
● Қысым: Газ тасымалдау және реакция жолына әсер етеді.
● Газ ағындары және қатынасы: Өсім жылдамдығы мен допинг концентрациясын анықтайды.
● Субстрат бетінің тазалығы: Кез-келген ластаушы заттар ақаулардың пайда болуы мүмкін.
● Басқа технологиялар: CVD негізгі құрал болғанымен, молекулалық сәуле эпитакси (MBE) сияқты технологияларды кремний эпитаксиі үшін, әсіресе ғылыми-зерттеу, әсіресе жоғары дәлдікті қажет ететін арнайы қосымшалар үшін де қолдануға болады.MBE кремнийді ультра жоғары вакуумдық ортада буландырады, ал атом немесе молекулалық сәулелер тікелей субстратқа өсу үшін субстратқа бағытталған.
Silicon Epitaxy технологиясы кремний материалдарының қолданылу аясын едәуір кеңейтті және көптеген алдыңғы жартылай өткізгіш құрылғыларды өндірудің ажырамас бөлігі болып табылады.
● CMOS технологиясы. Бұл эпитаксиалды кремнийдің вафли құрылымы кірпіктердің әсерін (ысырманы) тиімді түрде баса алады, құрылғының сенімділігін арттыра алады және ағымдағы өткізгіштік пен жылуды таратуға ықпал ететін субстраттың төмен төзімділігін сақтай алады.
● Биполярлы транзисторлар (BJT) және BICMOS: Бұл құрылғыларда, кремний эпитаксиі базалық немесе коллектордың аймақтары сияқты құрылымдарды дәл салу үшін қолданылады, мысалы, топырақ немесе транзистордың пайда, жылдамдығы және басқа сипаттамалары эпитаксиальды қабаттың допинг концентрациясы мен қалыңдығын бақылау арқылы оңтайландырылған.
● Сурет сенсоры (ТМД): Кейбір суреттер сенсорының қосымшаларында эпитаксиальды кремний вафалары пиксельді электр оқшаулауын, кросс-конверсия тиімділігін оңтайландыруға және оңтайландыруға мүмкіндік береді. Эпитаксиальды қабат тазартқыш және аз ақаулы белсенді аймақ ұсынады.
● Озық технологиялық түйіндер: Құрылғының мөлшері қысқартуды жалғастырады, өйткені материалдық қасиеттерге қойылатын талаптар жоғарырақ және одан жоғары. Silicon Epitaxy технологиясы, соның ішінде селективті эпитаксиалды өсу (SEG), сонымен қатар, тасымалдаушының ұтқырлығын жақсарту және транзисторлардың жылдамдығын арттыру үшін белгілі бір учаскелер (SEG) силиконның эпитаксиальды қабаттары (сарға) эпитаксиальды қабаттарын өсіру үшін қолданылады.
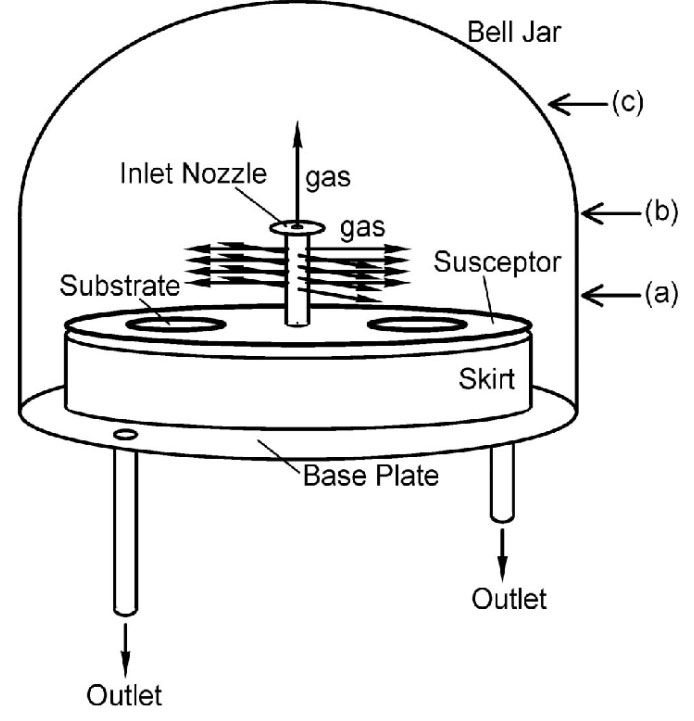
Горизоналды эпитаксицептурациясы Силикон эпитаксиіне арналған
Silicon Epitaxy технологиясы толығымен жетіліп, кеңінен қолданылады, бірақ кремний процесінің эпитаксиальды өсуінде қиындықтар мен проблемалар бар:
● Ақауды бақылау: Эпитаксиальды өсім кезінде жарықтар, дислокация, сырғанау сызықтары және т.б. сияқты әр түрлі кристалды ақаулар пайда болуы мүмкін. Бұл ақаулар электр өнімділігіне, сенімділікке және құрылғының кірістілігіне айтарлықтай әсер етуі мүмкін. Бақылау ақаулары өте таза қоршаған ортаны, процесс параметрлерін оңтайландырды және жоғары сапалы субстраттарды қажет етеді.
● Бірліктер: Цитаксиальды қабаттың қалыңдығына қол жеткізу және үлкен өлшемді кремний вафлиіне (мысалы, 300 мм) допинг концентрациясы болып табылады. Біркелкілік бірдей вафлидегі құрылғының жұмысындағы айырмашылықтарға әкелуі мүмкін.
● Автоматты пайдалану: Эпитаксиальды өсу процесінде, субстратта жоғары концентрацияланған доптанттар өсіп келе жатқан эпитакси қабаттарына газ фазасы диффузиясы немесе қатты күйдегі диффузия арқылы кіруі мүмкін, әсіресе эпитаксиалды қабаттағы, әсіресе эпитаксиальды қабат пен субстрат арасындағы интерфейстің жанында. Бұл кремний эпитакси процесінде шешілуі керек мәселелердің бірі.
● Жер үсті морфологиясы: Эпитаксиальды қабаттың беті өте тегіс болуы керек, ал кез-келген қаттылық немесе беттік ақаулар (мысалы, тұман сияқты) литография сияқты процестерге әсер етеді.
● Құны: Кәдімгі жылтыратылған кремний вафкестерімен салыстырғанда эпитаксиальды кремнийдің вафли өндірісі қосымша шығындар мен жабдықтарға инвестициялар қосады, нәтижесінде жоғары шығындар пайда болады.
● Селективті эпитаксидің сын-қатерлері: Жетілдірілген процестерде эпитаксиальды өсу (тек белгілі бір жерлерде өсу) процесті басқару бойынша жоғары талаптарды, мысалы, өсу қарқынының, бүйірлік өсуді бақылау және т.б.
Жартылай өткізгіш материалдарды дайындаудың негізгі технологиясы ретінде, негізгі ерекшелігіСиликон эпитаксиіБір кристалды кремсон субстраттарындағы нақты электрлік және физикалық қасиеттері бар жоғары сапалы бір кристалды эпитальды силикон қабаттарын дәл өсіру мүмкіндігі. Silricon Epitaxy процесінде температура, қысым және ауа ағындары сияқты параметрлерді дәл бақылау арқылы, қабықтың қалыңдығы мен допингтік үлгіні әр түрлі жартылай өткізгіш қосымшалардың қажеттіліктерін қанағаттандыру үшін, мысалы, CMOS, PEOTURSERS және сенсорлар.
Кремнистің эпитаксиалды өсуі ақауларды бақылау, біркелкілік, өзіндік допинг және шығындар, сонымен қатар технологияның үздіксіз дамуы, семитүкторлы құрылғылардың жұмысын жақсарту үшін, оның эпитаксиальды сметалық-вафлиді өндірісінің негізгі қозғаушы күштерінің бірі болып табылады.



+86-579-87223657


Вангда жолы, Зияг көшесі, Вуй округ, Джинхуа қаласы, Чживян провинциясы, Қытай
Авторлық құқық © 2024 Vetek Semicontustor Technology Co., Ltd. Барлық құқықтар қорғалған.
Links | Sitemap | RSS | XML | Privacy Policy |
